完全表面を測る-加工表面の評価と評価技術の開発-
固体表面電子構造の原子サイズ計測
STM-AES・XMA(Scanning Tunneling Microscopy-Auger Electron Spectroscopy・X-ray Microanalysis)の開発
光の回折限界を超える表面粗さ計測
SNOM(ScanningNear-field Optical Microscopy)の開発
表面上のナノメータオーダの微粒子計測
レーザー光散乱法による微粒子計測法の開発
シンクロトロン放射光を利用した表面・界面の構造解析
EXAFS法
固体表面電子構造の原子サイズ計測
STM-AES・XMA(Scanning Tunneling Microscopy-Auger Electron Spectroscopy・X-ray Microanalysis)の開発
固体表面の原子サイズでの元素分析を行なう方法としてSTM-AES・XMAを開発しています。これは、STMの探針にパルス電圧印加し、放出される一次電子を試料表面原子一個に照射し、そこから発生する原子固有のオージェ電子や特性X線をエネルギー分析することから元素分析や電子状態の計測を行う方法であります。シリコンウエハや放射光用ミラーの表面における不純物分析、EEMやプラズマCVMにおける固体表面化学反応素過程の原子レベルでの解析に利用します。

 「完全表面を測る」のトップへ
「完全表面を測る」のトップへ
光の回折限界を超える表面粗さ計測
SNOM(ScanningNear-field Optical Microscopy)の開発
EEMやプラズマCVM等の超精密加工表面の評価に不可欠なあらゆる材質の試料に対してナノメータオーダの空間分解能を有する微小突起をプローブとした走査型近接場光学顕微鏡の開発をしています。本顕微鏡は、光を電場の振動と捉らえ、球状微小突起プローブ中で光を電子の振動に変換し、試料表面がこの電場の振動と直接相互作用する領域まで近付いたときに、プローブ中で生じる電場の大きな変化に基づいて放射される光を検出し、この検出光量を一定に制御することによって表面微細構造を計測する走査プローブ顕微鏡の一種です。現在、光の回折限界を越える横10nm程度、縦2nm以下の分解能を達成しています。
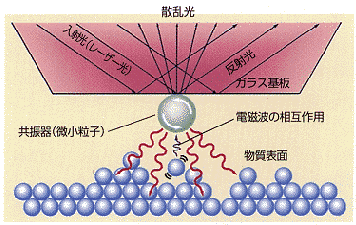
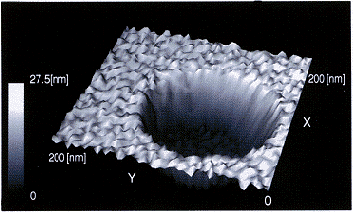 「完全表面を測る」のトップへ
「完全表面を測る」のトップへ
表面上のナノメータオーダの微粒子計測
レーザー光散乱法による微粒子計測法の開発
収束レーザー光を走査しながら照射し、超精密加工表面上の微粒子からのレーリー散乱光を楕円面鏡で集めて検出し、その粒径をナノメータオーダで測定する新しい方法です。図に示すように、シリコンウエハを計測し、粒径19nmに相当する信号を検出しています。これは、従来に比べて1オーダ以上検出感度を高めたことになります。シリコンウエハや放射光用ミラー等の超精密加工表面の微粒子を検査し、さらに散乱光から表面マイクロラフネスを推定し、加工表面を総合的に評価します。
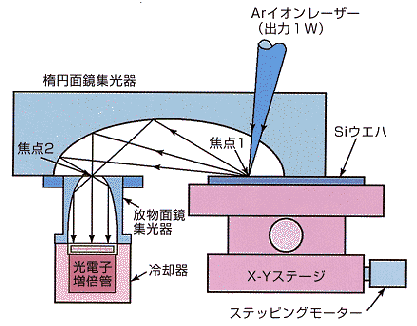
 「完全表面を測る」のトップへ
「完全表面を測る」のトップへ
シンクロトロン放射光を利用した表面・界面の構造解析
EXAFS法
波長可変の大強度で方向性のそろった光「シンクロトロン放射光」は、様々な材料の原子構造、電子状態を測定・解析することに広く利用されています。特にX線は、その波長が原子の大きさと同程度であることから、原子スケールでの微視的又は局所的な情報を得ることが可能です。X線を利用した表面・界面の構造解析手段の一つに、広域X線吸収端微細構造(EXAFS)法があります。EXAFS法は、原子がX線を吸収する際に発生する光電子の進行波と、近傍の原子により散乱された光電子波の干渉の結果、遷移モーメントが変調されて微細構造が生じる現象を利用して物質の局所構造を調べる手法で、中心原子の種類を選択し、中心原子の周囲の原子の数とそこまでの距離を精度よく決定することができるという特徴があります。EXAFS法により解析された局所構造の例として、InP基板上に成長させた一原子層InP1-xAsx超薄膜においてAsの組成比を増加させたときの、超薄膜中界面付近の結合長緩和の様子を示します。
 「完全表面を測る」のトップへ
「完全表面を測る」のトップへ
www-admin @prec.eng.osaka-u.ac.jp
Last revised on Mar. 25, 1998 by M. Nakano